TO封装引线键合等离子清洗应用
文章出处:等离子清洗机厂家 | 深圳纳恩科技有限公司| 发表时间:2022-04-30
压力传感器TO封装是一种低成本的封装形式,属非气密封装,主要用于监测非腐蚀气体和与干燥空气介质兼容的气体。其应用领域包括汽车仪表、医药卫生、气体控制系统、空调、制冷设备、环境监测和仪器仪表等。TO封装属于传感器的一次封装,在使用时需根据其应用环境对传感器进行二次封装,以满足性能和可靠性要求。
如图1所示为TO封装的压力传感器结构图。图中所示的压力传感器是绝压芯片。TO封装的工艺包括芯片与玻璃的静电键合、贴片、引线键合、封帽及涂胶保护。
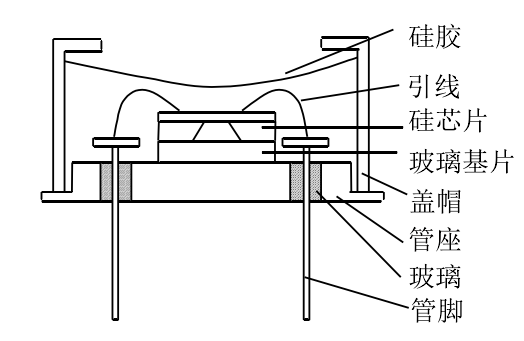
TO封装压力传感器结构
TO封装外壳
TO金属外壳管座常用材料有CuW(10/90)6.5×10-6/K(25℃-500℃)、可伐(Kovar),即Ni-Fe合金和不锈钢等,其中可伐(Fe-Ni-Co)合金最常用,这些材料都具有很好的热导率和比硅要高的热胀系数。可伐材料较便宜,它的热膨胀系数为5.3×10-6/K(40-250℃),与玻璃焊料的热膨胀系数很接近,容易用玻璃焊料在管座上焊接管腿。管座通常要镀Ni、Cu、Ag和Au薄膜。TO封装盖子常用钢带冲压工艺制成,盖子通常仅镀Ni。CuW的导热性能更好,常用在电力电子器件、功率及微波器件中。
TO管座上的管腿常用可伐丝做成,可伐丝的直径有0.4、0.45、0.5、0.6、0.8mm等,管腿和管座之间通过玻璃绝缘子焊接在一起。管腿与管座焊接完成之后,要求具有气密性,并能承受4Kg以上的压力。TO封帽常用储能焊接工艺完成,并要求焊缝具有气密性。
尽管芯片互连有多种工艺形式,但目前引线键合工艺仍然是芯片互连的主要技术。如何提高引线键合强度,仍是需要进行研究的问题。
清洗工艺对提高引线键合强度至关重要。在引线接合之前,从键合焊盘表面清除所有的污染物显得特别重要。目前清洁焊盘的工艺方法有等离子体清洗、超声清洗、紫外光清洗等,其中,使用射频驱动的低压等离子清洗技术是一种有效的、低成本的方法。
等离子清洗技术是微电子工艺干法化研究的成果之一。与湿法清洗不同,等离子清洗的机理是依靠处于“等离子态”的物质的“活化作用”达到去除物体表面污渍的目的。等离子清洗技术能有效的清除金属、陶瓷、塑料表面的有机污染物,可以显著增加物体的表面能,提高浸润性和粘合性,达到提高焊接强度的效果。从目前各类清洗方法来看,等离子体清洗也是所有清洗方法中最为彻底的剥离式的清洗。
随着半导体行业不断向小型化微型化发展,对半导体的封装设计也提出了更高的要求。高质量的封装技术可以提高电子产品的寿命。封装过程中各键合部分的键合强度不足、焊球分层或脱落成为制约半导体发展的重要因素,必须在不破坏材料表面特性的前提下,有效清除各类污染物,将等离子清洗引入TO封装中,能够显著改善封装的可靠性和质量。