功率模块DBC基板焊接前等离子清洗
文章出处:等离子清洗机厂家 | 深圳纳恩科技有限公司| 发表时间:2025-11-20
目前商用功率模块仍采用传统封装技术,封装结构如图1-1(a)所示,功率模块主要由功率芯片、续流二极管、键合线、直接覆铜陶瓷基板(DirectBondCopper,DBC基板)和功率端子构成。DBC基板具有为上层导电铜层、中间绝缘陶瓷层、下层散热铜层三明治结构。芯片焊接在DBC基板上,通过引线键合工艺,实现芯片表面电极与功率、控制端子之间的连接,外壳内填充灌封胶以起到绝缘与密封作用。
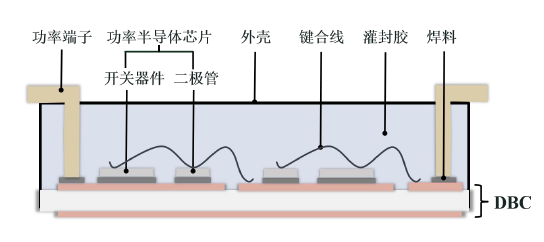
图1-1 引线键合式半桥功率模块封装基本结构
DBC表面铜层易与空气接触而发生氧化,严重影响引线键合质量及芯片焊接效果,需要将DBC进行等离子清洗,以去除铜金属表面氧化层,增强表面活性从而提高DBC与芯片、芯片与垫片之间焊接界面的强度。
等离子清洗方式主要分为化学方式清洗和物理方式清洗,其中除了惰性气体(如:AR)为纯物理方式清洗,其余气体电离后的等离子清洗均为物理和化学方式联合清洗。具体工作原理如图3-5所示:在一个密闭腔体中,利用真空泵获得较低的真空度,射频电源将信号反馈到上极板上,在上、下极板之间产生交变电场。充入的工艺气体在电场中被电离,形成高密度等离子体,随后在其与电场的相互作用下,产生偏转电压,向下轰击待清洗样品表面,轰击后产生的离子或气体,在真空泵的抽离下排出腔体。
功率模块DBC基板焊接前等离子清洗
焊膏只有在液体状态才能与焊盘润湿并共晶键合,其润湿性受表面能和表面张力影响,表面能越高,焊膏越容易发生扩散和润湿。单独的稀盐酸化学处理,可以除去样品表面的氧化铜,但是对表面能的提升不够彻底。因此在焊接产品的前处理过程中补充了等离子清洗工艺,通入H2气体,在其辉光放电过程中,能够通过还原反应,去除氧化铜及其他氧化物杂质,同时通入的Ar气体,其等离子态具有较高的能量,以物理轰击的方式清洗样品表面尘垢、油污等,对氧化物也有一定的清洗效果。
补充等离子清洗后,虚焊情况可以得到改善:等离子体中含有大量的电子、离子、激发态的分子原子、自由基及紫外光等活性粒子,这些粒子的能量在0~20eV之间,大多数高分子材料键能在1~10eV左右,处于等离子体的作用范围内,表面改性效果十分明显。
DBC基板上铜层等离子清洗前后对比如图2所示。需要注意的是,等离子清洗时间不宜过长,防止铜片过度发热,在设备破真空环节发生氧化。