等离子体刻蚀技术是去除器件表面物质的一种重要工艺技术。现在最常用的刻蚀技术是干式刻蚀法,它利用等离子体轰击半导体器件表面产生可挥发气体进行刻蚀,包括溅射、纯化学刻蚀、离子能量驱动刻蚀和离子-阻挡层复合作用刻蚀这四种方法,如图1.1所示。与前期的湿式刻蚀法相比,它的优点在于:刻蚀速率高,不会使器件受到腐蚀,具有很好的各向异性刻蚀。因此,被广泛应用于亚微米尺寸下器件的刻蚀。
溅射是指载能离子轰击材料表面,材料表面的原子会被溅射出来,而载能离子是由等离子体能提供的。在溅射刻蚀过程中,溅射是各向异性的过程,溅射的产率对离子的入射角非常敏感,而且溅射出的原子的平均自由程必须足够长,以防止它们在材料表面重新沉积。
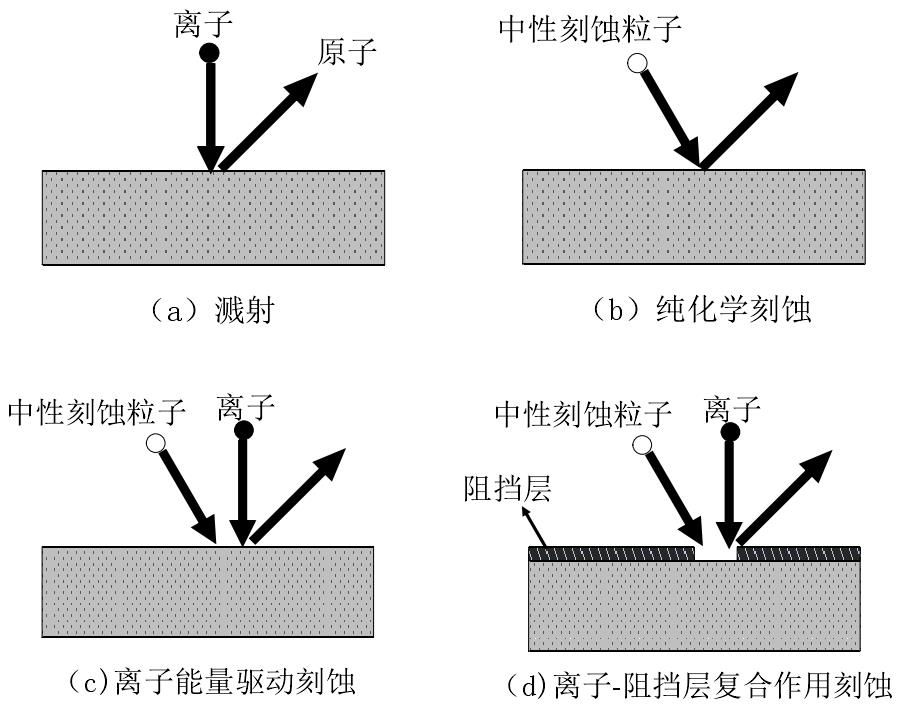
图1.1 四种基本的等离子体刻蚀工艺过程
等离子体化学刻蚀原理:
纯化学刻蚀是指在该过程中等离子体只提供气相的刻蚀原子或分子,它们与材料表面发生化学反应生成可挥发产物。例如:
Si(s)+4F→SiF4(g)
光刻胶+O2(g)→CO2(g)+H2O(g)
纯化学刻蚀几乎是各向同性刻蚀,其刻蚀速率主要由能形成刻蚀产物的一组复杂反应中的某一个反应决定。
离子能量驱动刻蚀是指等离子体即可提供刻蚀粒子还可提供载能离子,是溅射和纯化学刻蚀的综合,其刻蚀速率由载能离子的轰击能量决定。
离子-阻挡层复合作用刻蚀是在刻蚀过程中等离子体能提供刻蚀粒子和载能离子,还需要提供能形成阻挡层的分子,该分子可以沉积在材料表面形成保护膜。
光刻胶(PhotoResist)根据其化学反应机理和显影原理分为正光刻胶和负光刻胶。正光刻胶在曝光前后,其增感剂由溶解抑制剂变成能溶解增强剂,而负光刻胶刚好相反。因此在半导体光刻的步骤中,利用这种性能将光刻胶作涂层,经过曝光部分的正光刻胶会溶解,在基底表面刻蚀得到所需的图像。光刻胶掩膜材料主要由碳、氢组成的长链有机聚合物形成的,可以用氧气等离子体各向同性地从晶圆上刻蚀光刻胶掩膜材料产生二氧化碳、一氧化碳等挥发性气体。如图1.2所示是光刻胶刻蚀技术,经过光刻后的薄膜会暴露在表面,需要用干式刻蚀方法即等离子体刻蚀基底表面的薄膜。影响光刻胶刻蚀速率的主要因素是活性氧原子的数量。
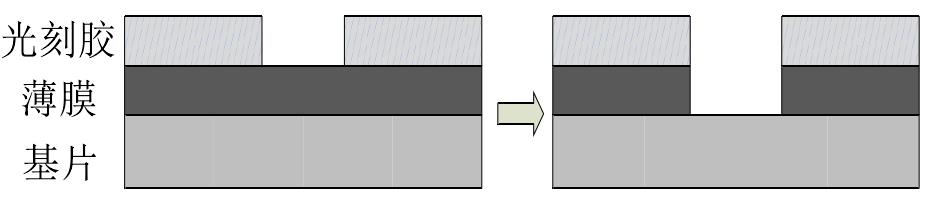
图1.2光刻胶刻蚀技术
等离子刻蚀原理视频介绍: