反应离子刻蚀(RIE)
通常,干法刻蚀可分为三类:溅射(物理)刻蚀,等离子刻蚀PIE(PE)和反应离子刻蚀RIE。
物理刻蚀
溅射(物理)刻蚀的特点是物理作用,惰性气体经电离后的气体离子轰击刻蚀样品表面发生溅射,从而达到刻蚀的目的。其方向性好,但选择性差,刻蚀的速率决定于刻蚀膜的溅射率。
化学刻蚀
等离子刻蚀(化学刻蚀)工艺是利用气体在高频电场中辉光时产生的化学活性基与欲刻蚀的材料发生化学反应来进行选择性刻蚀的方法,反应生成挥发性物质被抽走:另一方面,辉光放电等离子体具有一定的电离气体离子,在电场的作用下会向样品表面轰击,起到促进化学反应的作用,加速刻蚀的进行。总的来说,这种工艺的各向异性差,且过刻蚀时产生倒蚀现象。PE是各向同性腐蚀技术,即同一种材料沿多个方向进行均匀腐蚀,腐蚀后金属化层与介质层间的接触面积减小,金属化层会向上升高,脱离介质层,容易造成样品新的失效模式。
反应离子刻蚀
把物理作用的溅射刻蚀与化学反应的等离子刻蚀结合起来,就是反应离子刻蚀(RIE)。反应离子刻蚀的机理就是RF溅射刻蚀工艺通过以反应性气体或掺入反应性气体于惰性气体中,因而使RIE既有离子轰击作用,又有化学反应。速度快,方向性均好。
例如氮化硅反应离子刻蚀(RIE)的原理如下:
反应离子刻蚀与等离子刻蚀去钝化层有相似之处,在RIE过程中,既有辉光放电条件下活性气体粒子与固态si表面的化学反应过程,也有这些能量很大的粒子轰击溅射si表面的物理过程。后一过程有助于清除表面吸附物,并引起固体表面晶格损伤,在表面几个原子层内形成激活点,这些活性点便于游离基的化学反应,增加腐蚀速率。同时,这种轰击腐蚀作用有助于提离刻蚀侧墙的垂直性。
氮化硅反应离子刻蚀(RIE)是主要利用氟基气体,以及氧气氩气等组合,通过启辉放电,使得反应腔室气体产生等离子体,其主要包括分裂形成具有化学活性的活性自由基,电离形成更多的电子和离子。RIE系统原理如图1所示,启辉放电过程中,产生的活性自由基F到达薄膜表面进行化学反应,产生的挥发性物质随废气排出,而带电离子则对薄膜进行物理轰击,二者相互促进刻蚀,以得到良好的形貌。
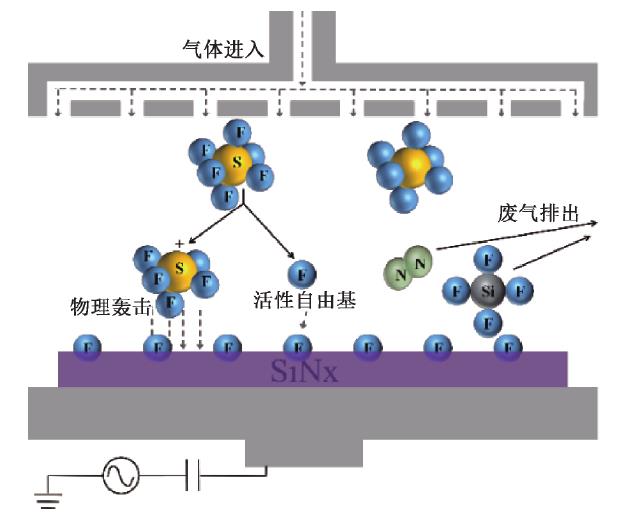
SF6 刻蚀氮化硅原理
例如采用SF6作为氮化硅的刻蚀气体,SF6与氮化硅进行化学反应,具体反应过程机理如下:
SF6+e-→SF5++F+2e-
SiNx+4F→SiF4↑+N2↑
式中:SF5+表示具有物理轰击作用的带电离子,F表示较强的化学反应性的活性自由基,反应产生的SiF4是极易挥发的气体,通过真空系统及尾气处理装置排出反应腔室,以达到刻蚀目的。
RIE兼具了材料选择性和方向性,是各向异性刻蚀技术,刻蚀方向垂直于材料表面,刻蚀后金属化层与介质层之间的接触面积不会减小。
PE(等离子蚀刻)模式和RIE(反应离子蚀刻)模式之间的差异:
 PE蚀刻过程是各向同性的,这意味着等离子体从各个方向冲击到工件上。腐蚀是无方向性的。
PE蚀刻过程是各向同性的,这意味着等离子体从各个方向冲击到工件上。腐蚀是无方向性的。
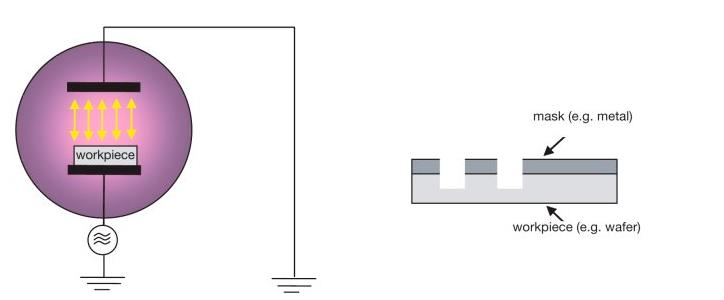
RIE刻蚀过程是各向异性的;这意味着定向等离子几乎垂直地撞击工件