ICP(感应耦合)等离子刻蚀机的基本原理及结构示意图
文章出处:等离子清洗机厂家 | 深圳纳恩科技有限公司| 发表时间:2022-10-18
随着半导体工艺技术的发展,湿法刻蚀由于其固有的局限性,已不能满足超大规模集成电路微米、甚至纳米级细线条的工艺加工要求,干法刻蚀逐渐发展起来。在干法刻蚀中,感应耦合等离子体(Inductively Coupled Plasma简称ICP)刻蚀法由于其产生的离子密度高、蚀刻均匀性好、蚀刻侧壁垂直度高以及光洁度好,逐渐被广泛应用到半导体工艺技术中。
1 ICP等离子刻蚀机的基本原理及结构
1.1 基本原理
感应耦合等离子体刻蚀法(InductivelyCou-pledPlasmaEtch,简称ICPE)是化学过程和物理过程共同作用的结果。它的基本原理是在真空低气压下,ICP射频电源产生的射频输出到环形耦合线圈,以一定比例的混合刻蚀气体经耦合辉光放电,产生高密度的等离子体,在下电极的RF射频作用下,这些等离子体对基片表面进行轰击,基片图形区域的半导体材料的化学键被打断,与刻蚀气体生成挥发性物质,以气体形式脱离基片,从真空管路被抽走。
1.2 ICP等离子刻蚀机的结构
ICP等离子刻蚀机其设备主要结构包括预真空室、刻蚀腔、供气系统和真空系统四部分,如图1所示。
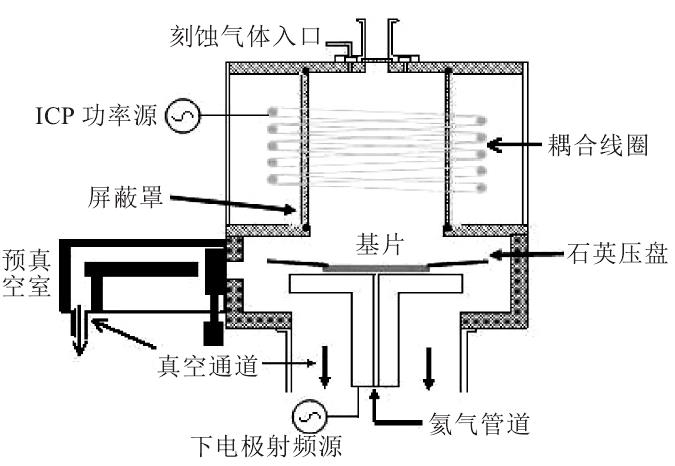
图一 ICP 等离子刻蚀机设备结构示意图
1.2.1预真空室
预真空室的作用是确保刻蚀腔内维持在设定的真空度,不受外界环境(如:粉尘、水汽)的影响,将危险性气体与洁净厂房隔离开来。它由盖板、机械手、传动机构、隔离门等组成。
1.2.2刻蚀腔体
刻蚀腔体是ICP等离子刻蚀设备的核心结构,它对刻蚀速率、刻蚀的垂直度以及粗糙度都有直接的影响。刻蚀腔的主要组成有:上电极、ICP射频单元、RF射频单元、下电极系统、控温系统等组成,如图2所示。

图二 ICP等离子刻蚀机腔体
(1) 上电极。上电极下表面布满均匀小孔,它的功能是将刻蚀气体均匀输送到ICP的腔体的圆截面,以便等离子体的制备。
(2) ICP射频单元。ICP射频单元主要由射频发生器、匹配网络、射频电缆以及耦合线圈、隔离装置组成。在ICP射频单元作用下,刻蚀气体经辉光放电,耦合感生出大量的等离子体。
(3) RF射频单元。RF射频单元由RF射频发生器、匹配网络和射频电缆组成。射频电缆的另一端接到下电极底部。提供等离子体的偏转电压。
(4) 下电极系统。下电极系统主要包括下电极板、基座、石英压盘、氦气单元、下电极冷却系统等结构。其主要作用是将RF射频发生器提供的能量加到基片上。
(5) 控温系统。为了保证刻蚀的均匀性和重复性,刻蚀腔的温度一定要精准的控制。温度的控制由高精度的温控器来控制。
1.2.3供气系统
供气系统是向刻蚀腔体输送各种刻蚀气体,通过压力控制器(PC)和质量流量控制器(MFC)精准的控制气体的流速和流量。气体供应系统由气源瓶、气体输送管道、控制系统、混合单元等组成。
(1) 气源瓶。各种刻蚀气体最初都单独存放在气源瓶内,纯度达到99.9%以上,经由控制系统输送到混合单元,再送到刻蚀腔内,产生等离子体。
(2) 气体输送管道。气体输送管道包括两部分。一是刻蚀气体的从气源瓶往刻蚀腔的输送,另外一部分是刻蚀产生的挥发性气体的排空线。
(3) 气体控制系统。控制系统包括阀门、质量流量控制器、压力控制器等。
(4) 混合单元。混合单元将各刻蚀气体在该单元进行混合,形成一定比例的均匀混合气体,再进入ICP射频单元,感应耦合形成等离子体。
1.2.4真空系统
真空系统有两套,分别用于预真空室和刻蚀腔体。预真空室由机械泵单独抽真空,只有在预真空室真空度达到设定值时,才能打开隔离门,进行传送片。刻蚀腔体的真空由机械泵和分子泵共同提供,刻蚀腔体反应生成的气体也由真空系统排空。
ICP刻蚀技术作为一种新兴的高密度等离子体刻蚀技术,在对硅、二氧化硅材料、等材料的刻蚀方面获得了很好的效果,已被广泛应用到了各种器件的制作工艺中。