等离子清洗在倒装芯片封装底部填充工艺流程中的作用
文章出处:等离子清洗机厂家 | 深圳纳恩科技有限公司| 发表时间:2023-07-21
底部填充工艺作为倒装芯片封装中用来提高连接凸点可靠性的一种重要方法正受到越来越多的关注和研究。
底部填充的定义
底部填充一般的定义是指利用化学胶水(主要成份是环氧树脂)对采用倒装互连模式的芯片进行下填充,然后通过加热方式使胶水固化,是用来增强倒装芯片封装产品中连接凸点的抗应力能力和抗跌落性能的一种技术。
部填充工艺的主要作用
底部填充的作用主要有如下几点:(1)为倒装互连系统中的连接凸点提供有效的机械支撑;(2)保护倒装互连系统中的连接凸点免受环境中的湿气,杂质以及其他元素的影响;(3)将产品所受到的热应力均匀地分布在芯片和基板上,防止连接凸点由于热疲劳失效,提高产品的可靠性和服役时间。
底部填充工艺的类型
底部填充工艺中共有三类填充方式,分别是压力驱动式、非流动式和毛细驱动式三种,图1-1为三种填充方式的示意图。这三种方式在原理和方法上有所差别,当今行业中主要使用的是毛细驱动式填胶,该方式是利用点胶设备在产品边缘喷射底填胶,胶水在流体表面张力和“毛细现象”的共同作用下,流进布满着连接凸点的芯片底部,填充芯片和基板之间的所有缝隙,约九成以上的封测企业采用这种填胶方式。

图1.1 常见的三种底部填充方式
底部填充工艺的流程
一套严格且完整的底部填充工艺在实施过程中一般包含预烘烤、清洗、填充、固化和检验等步骤,每个步骤的需要达到目的不同,工艺实施过程中需要对参数和操作规范性进行严格把控,否则容易引入额外异常,达不到预期的点胶效果。
等离子清洗在底部填充工艺流程中的作用
等离子清洗是清洗设备通过内部的电磁场使氩气或氢气等气体激发出等离子态,等离子体再去轰击待清洗产品的表面,通过轰击过程中发生的物理和化学反应,达到清洗的目的。其中,物理反应机制是活性粒子轰击待清洗表面,使污染物脱离表面最终被真空泵吸走。化学反应机制是各种活性的粒子和表面的污染物反应,生成易挥发性的物质,再由真空泵吸走挥发性的物质。等离子清洗的主要目的是改善基板表面的粗糙度,清除污染和杂质,为底部填充过程提供一个干净的环境,同时随着基板表面粗糙度的改善,胶液的流动性会更好,下图2为基板等离子清洗前后水滴角的变化。
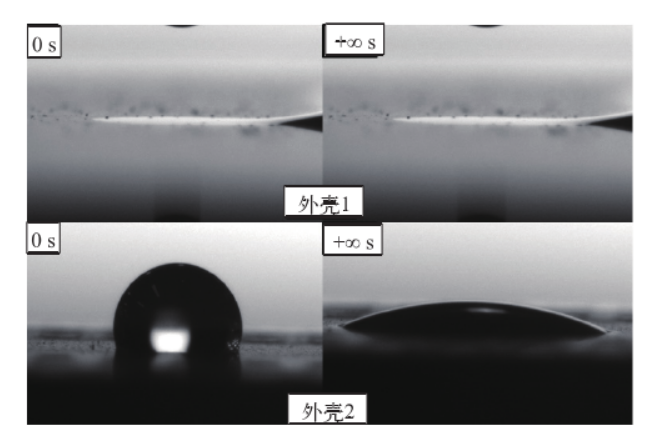
图2 等离子清洗前后外壳表面的水滴角对比
以上资料由国产等离子清洗机厂家纳恩科技整理编辑!!!通过等离子清洗来控制倒装后的外壳表面一致性,以此来避免外壳表面存在一些对底部填充起到阻碍作用的物质。等离子清洗可以有效提升外壳表面的浸润性,有利于底部填充胶的扩散。